ドイツ・CCR社製、ICP方式のプラズマソースです。ヨーロッパのほぼすべての装置メーカーで、そのPVDアシスト用、またはPECVD用のプラズマソースとして採用されています。
●適用例:バッチチャンバーでの酸化、窒化アシスト
特徴1:CCR社独自技術により、1m以上の大型プラズマソースの納入実績多数
特徴2:CCR社独自技術により、蒸着、スパッタ、PECVDの各真空度に調整可能
特徴3:ICP方式な為、チャンバー汚染リスクが低く、メンテナンス負荷が低い
特徴4:ICP方式な為、投入パワーに伴うイオンエナジーの変化が少なく基板ダメージが少ない。
摘要1:スパッタ中の酸化、窒化アシスト
効果:メタルモード並みの成膜レートでリアクティブコーティング
摘要2:スパッタ真空域でのPECVD
効果:スパッタ装置にPECVDを組み込み可能
摘要3:PVD成膜前の、エッチング
効果:密着性の向上
摘要4:PVD成膜中のArアシスト
効果:成膜層の高密度化
註1:PVDアシスト評価用ユニットのお貸出し相談可
註2:PECVDデモ成膜相談可
●Copraシリーズと各対応真空度
| 真空度 (動作中心域) |
プロセス | モデル | ||
|---|---|---|---|---|
| 1E-1 mbar (1E1Pa) |
PECVD | RS Copra LS Copra |
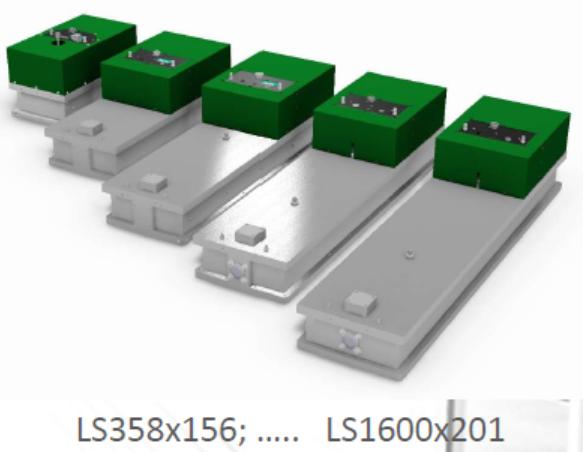 |
 |
| 1E-2 mbar (1Pa) |
スパッタ PECVD |
LS Copra DN Copra |
 |
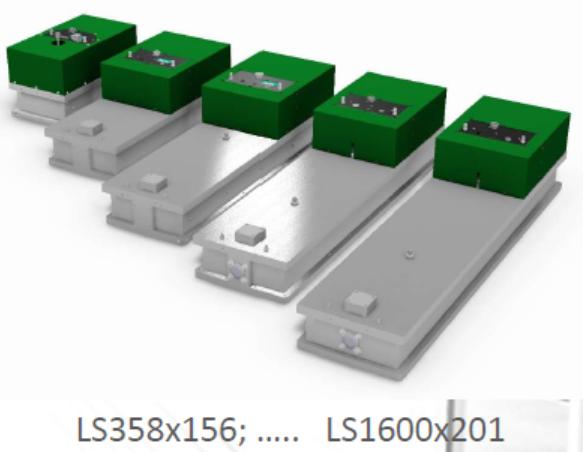 |
| 1E-3 mbar (1E-1Pa) |
スパッタ | LS Copra DN Copra |
 |
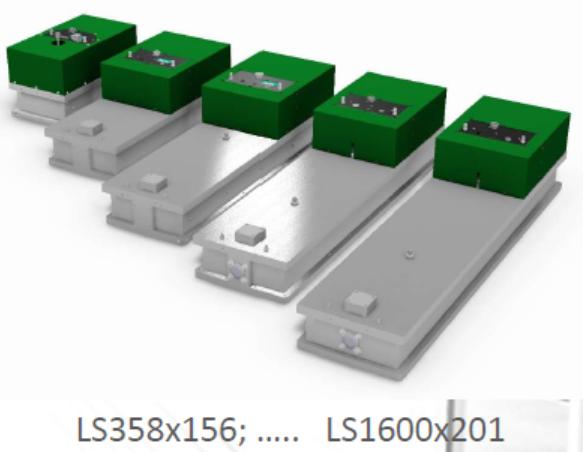 |
| 1E-4 mbar (1E-2Pa) |
Eビーム 蒸着 |
IS Copra |  |
|
●プラズマ発生方式:ICP(誘導結合プラズマ:Inductively Coupled Plasma)
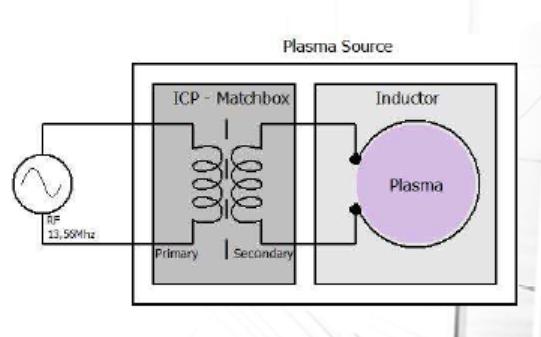
| HCD | CCP | ICP |
|---|---|---|
| 汚染リスク高い 大型基板への適用困難 |
汚染リスクが高い 大型基板への適用可能 |
汚染リスクが低い 大型基板への適用可能 |
●RF投入パワーに伴うイオンエナジーの上昇
註:投入パワーにかかわらず、イオンエナジ―は一定です。